Bộ bao bì SOW-X cạnh TSMC sườn được thiết lập để sản xuất hàng loạt vào năm 2027;Cung cấp công suất điện toán cao hơn 40 lần so với các giải pháp Cowos hiện tại
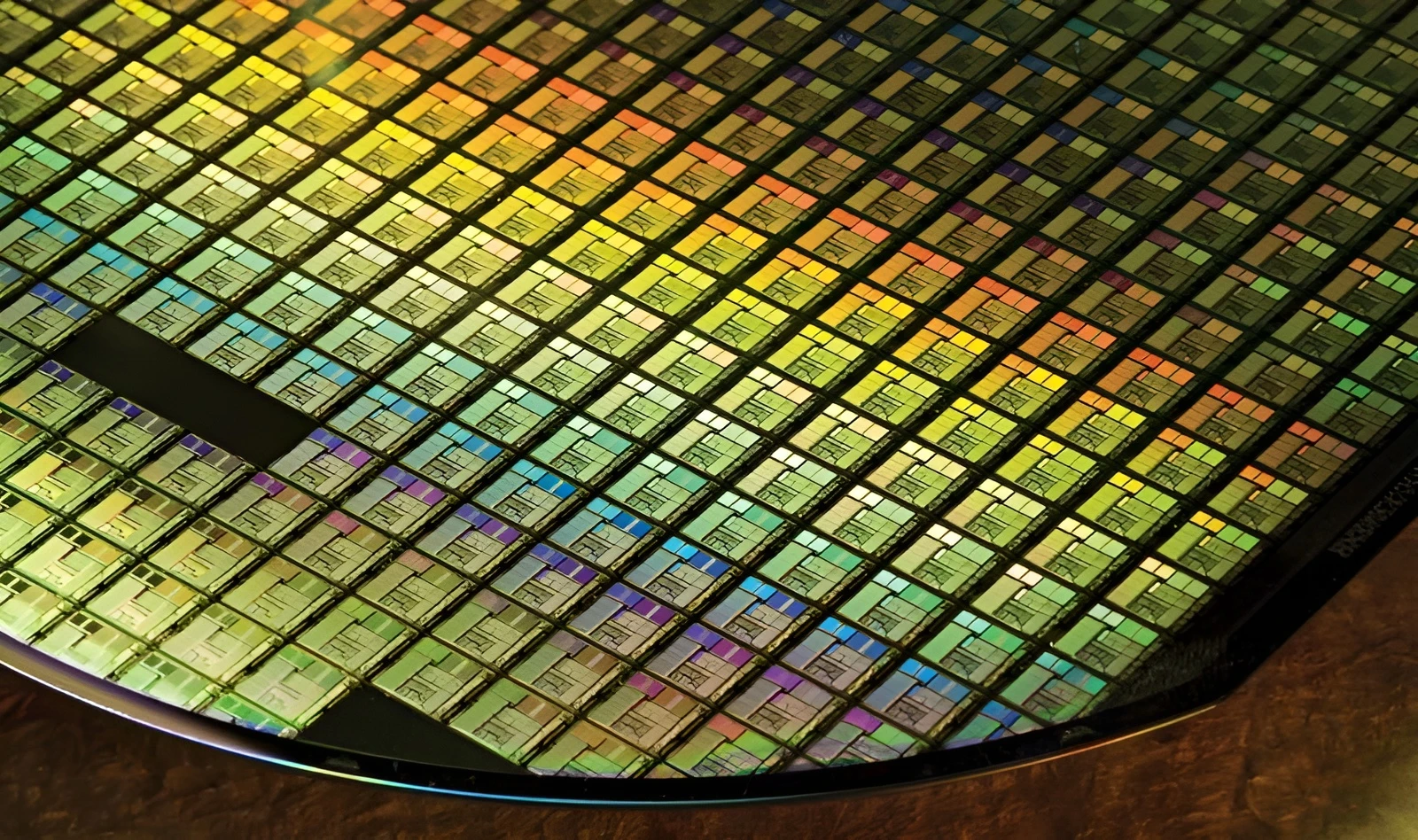
Ngoài các thông báo về bán dẫn, TSMC đã giới thiệu công nghệ đóng gói tiên tiến SoW-X tại Hội thảo Công nghệ. Công nghệ đóng gói SoW-X của TSMC được cho là nâng cao khả năng tính toán, mang lại hiệu suất cao. Đóng gói tiên tiến như CoWoS là một trong những cách mà các công ty như NVIDIA đã vượt qua định luật Moore và quy luật tăng hiệu suất thông thường của các thế hệ sản phẩm trước.
Bằng cách kết hợp các chip trên một wafer và nền tảng duy nhất, CoWoS đã mang lại sự cải thiện lớn về hiệu suất tính toán. TSMC cho biết họ đang phát triển các thế hệ CoWoS tiên tiến hơn, bao gồm các biến thể SoW và SoW-X mới, có khả năng vượt trội hơn so với các tùy chọn hiện tại. TSMC cũng dự kiến ra mắt một phiên bản CoWoS mới với 9.
Kích thước reticle 5x cho phép tích hợp lên đến 12 ngăn xếp HBM. Biến thể này dự kiến sẽ được sản xuất vào năm 2027 và có khả năng trở thành lựa chọn đóng gói phổ biến hơn so với các lựa chọn khác cùng thời điểm. Công nghệ CoWoS hiện tại có kích thước reticle 5.5x, vì vậy việc nâng cấp lên 9.5x là một thành công lớn đối với gã khổng lồ Đài Loan. Trong tương lai, TSMC dự định thay thế CoWoS bằng hệ thống SoW (System-on-Wafer) và đã cung cấp thông tin về công nghệ mới này trước đây.
Theo thông tin, SoW sẽ có giới hạn reticle gấp 40 lần và có tới 60 HBM stack, lý tưởng cho các ứng dụng AI quy mô lớn. Đồng thời, công ty Đài Loan cũng đã công bố biến thể mới, SoW-X, với thông tin chưa rõ ràng nhưng được cho là sẽ có sức mạnh tính toán cao gấp 40 lần so với giải pháp CoWoS hiện tại. Dự kiến, sản xuất hàng loạt cho các biến thể SoW sẽ bắt đầu vào năm 2027.
TSMC đã đạt được vị thế dẫn đầu trong lĩnh vực đóng gói chip tiên tiến và đang có kế hoạch thống trị thị trường một lần nữa, sau khi đã thành công với bộ giải pháp CoWoS.
Nguồn: wccftech.com/tsmc-cutting-edge-sow-x-packaging-set-for-mass-production-by-2027/